
Intel 針對目前採用先進封裝技術進行解說,並且期望將現行晶片 基板轉為玻璃材質設計,不僅將提高晶片基板強度,更可進一步增加能源傳遞效率。而透過共同封裝光學元件 (Co-Packaged Optics)技術,則將藉由轉為玻璃材質基板設計,透過光學傳輸方式增加資料交換可用頻寬,同時也能讓晶片對應熱插拔使用模式。
在Intel先前提出的IDM 2.0發展策略中,晶圓代工業務將成為Intel重要轉型項目,除了可藉由其產線資源協助更多如Qualcomm等晶圓設計業者製造產品,更期望透過其封裝技術單獨吸引更多業者採用,例如可由其它業者協助代工,並且透過Intel技術進行封裝、測試,以更具彈性方式增加其業務成長機會。
Intel表示,目前已經與全球前10大晶片封裝廠旗下客戶進行洽談,並且獲得Cisco、AWS在內業者青睞。


在先前說明中,Intel已經能針對小晶片架構、晶片混搭架構,藉由EMIB 2.5D及Foveros 3D技術進行封裝,而此類技術將持續推進,並且維持可合併使用方式。


另外,Intel先前也曾提及強化Foveros 3D封裝技術發展方向,包含以3D堆疊方式強化處理器die之間連接的Foveros Omni封裝技術,藉此對應更具彈性的處理器架構設計,而Foveros Direct則將作為Foveros Omni互補設計,兩項技術都預計在2023年投入應用。

至於在未來封裝技術發展部分,Intel計畫將現有晶片基板轉為玻璃材質,藉此提高晶片基板強度與能源傳遞效率,另外也將配合共同封裝光學元件技術,在基板轉為玻璃材質設計之下,可透過光學傳輸方式增加資料交換頻寬,同時也能讓晶片對應熱插拔使用模式。

而Intel預計在今年第二季提供相關樣品作為測試。
《原文刊登於合作媒體mashdigi,聯合新聞網獲授權轉載。》
訂閱《科技玩家》YouTube頻道!
💡 追新聞》》在Google News按下追蹤,科技玩家好文不漏接!
📢 Pixel 10a開箱親民價!平面鏡頭 實測拍照、AI生圖順手、還能用AirDrop
📢 蘋果「超強新品」MacBook Neo來了!平價筆電免2萬 4色搶美又輕巧
📢 蘋果最新舊換新Trade in價格出爐!iPhone 16更值錢 13款手機跌價
📢 蘋果iPhone 17e與iPhone 17差在哪?1表全解析 補足MagSafe
📢 LINE免費貼圖!初音未來超可愛、這款「狗沒拿賽」諧音哏滿滿
📢 M4 iPad Air和M3差在哪裡?一圖了解高CP值 果粉在意「萬年60Hz」



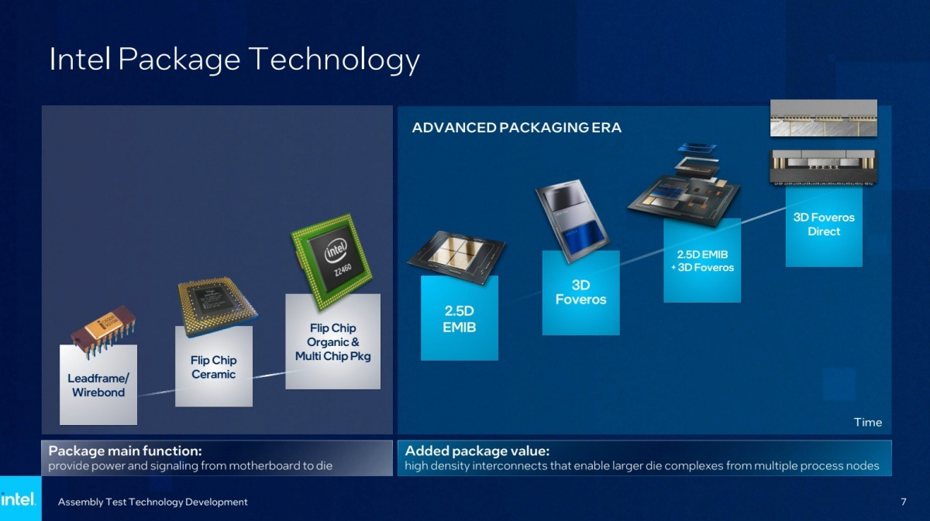







































討論區